DBG(Dicing Before Grinding)製程
解決方案
DBG製程
DBG就是將原來的「背面研磨
→切割晶片」的製程程序進行逆向操作,先對晶片進行半切割加工,然後利用背面研磨使晶片分割成晶粒的技術。經通運用該技術,能有效地抑制分割晶片時產生的背面崩裂及晶片破損,從而能夠順利地從大尺寸的晶片上切割出晶粒。
由於大幅度地減少了晶粒的背面崩裂現象,所以能夠在維持高抗折強度的同時,對於晶片進行超薄加工時,也能夠生產出高強度的晶粒。
另外,由於利用研磨機的研磨加工對晶片實施分離作業,所以可以有效地避免薄型晶片在搬運過程中的破損風險。
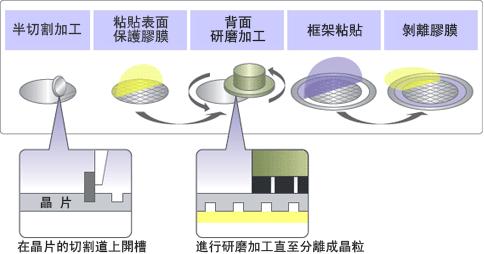
採用半切割用切割機對晶片表面的切割道上進行開槽加工。在通常的切割加工中,會切割到晶片背面,直至完全切斷。但是,在實施DBG製程時,只切割到所要求的晶片厚度尺寸為止。 完成半切割加工作業之後,先在晶片表面粘貼保護膠膜,再使用研磨機進行背面研磨加工。當研磨到事先切入的切割槽時,晶片會被分割成一個個晶粒(晶粒分離)。然後將完成分割作業的晶片利用連線搬運系統到DBG框架粘貼機上,首先進行位置校準作業,再粘貼到框架上,最後在剝離晶片的表面保護膠膜之後來完成整個工程。
相關情報
適用於DBG製程的產品介紹
https://www.disco.co.jp/cn_t/products/index.html?id=dbg

