SDBG(Stealth Dicing Before Grinding)工艺
解决方案
随着智能手机以及平板电脑的薄型化、大容量化的发展,市场对闪存( Memory)、内存控制器(Memory Controller)薄型化的要求也不断提升,使得在以往工艺中的极薄晶片处理以及切割时的崩裂问题更加面临挑战。
SDBG工艺,在解决这些课题的同时,又可以实现以下附加价值。
- 增加芯片获取数量
- 提高薄型芯片的抗弯强度
SDBG工艺
SDBG工艺是在隐形切割加工后再进行背面研磨的工艺技术,可实现薄型芯片的切割道狭窄化以及抗折强度的提升。
经由与分离扩片机(DDS Series)的组合运用,可将薄型芯片积层时作为接合材料所使用的DAF(Die Attach Film)高品质分割。
工艺流程
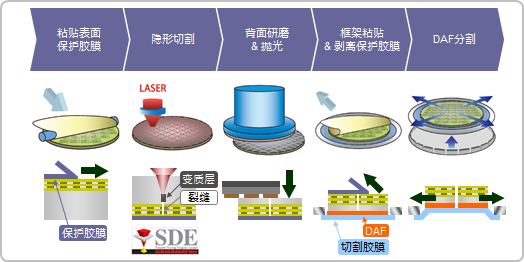
增加芯片获取数量
使用隐形切割加工时,刀痕宽度几乎为零,因此对切割道狭窄化大有贡献。与通常的刀片切割工艺相比,单位晶片可获取的芯片数量有望增加。
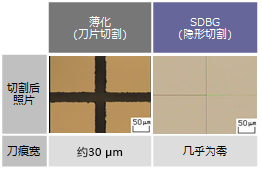
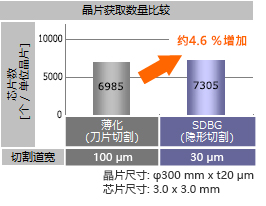
提高芯片抗折强度
刀片切割工艺在芯片表面、背面造成崩裂以及在晶片侧面留下的加工痕,都对抗折强度有所影响。 SDBG是使用隐形切割加工在晶圆内部形成变质层,再以此变质层为起点进行分割,最后通过研磨去除变质层部分的制程工艺。 因此,SDBG工艺不仅可以减少表面、背面的崩裂,并可制作出侧面无加工痕的高强度的薄型芯片。
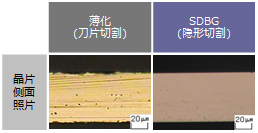
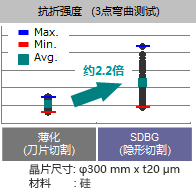
DAF(Die Attach Film)的高品质分割
使用分离扩片机(DDS Series)可将DAF在低温环境下以扩展方式进行高品质分割。
扩展后切割胶膜的松弛问题可通过热收缩使其恢复,因此无需重新粘贴切割胶膜,可直接搬运至下一阶段的键合工艺。
相关信息
适用于SDBG工艺的产品介绍
https://www.disco.co.jp/cn_s/products/index.html?id=sdbg

