什么是隐形切割TM加工?
隐形切割是将激光聚光于工件内部,在工件内部形成改质层,通过扩展胶膜等方法将工件分割成芯片的切割方法
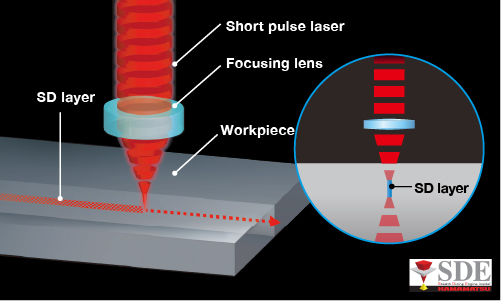

-
扩展胶膜前
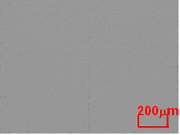
-
扩展胶膜后
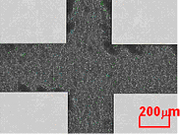
DISCO是隐形切割技术专利布局持有者浜松光子学公司的联盟伙伴*。
*获得隐形切割技术专利布局一揽子许可的相关业务的系统集成商
https://www.hamamatsu.com/jp/en/product/semiconductor-manufacturing-support-systems/stealth-dicing-technology/alliance-partners.html
隐形切割TM加工的优点
- 由于工件内部改质,因此可以抑制加工屑的产生。适用于抗污垢性能差的工件
- 适用于抗负荷能力差的工件(MEMS等),且采用干式加工工艺,无需清洗
- 可以减小切割道宽度,因此有助于减小芯片间隔
隐形切割TM加工的实例
MEMS切割
在MEMS芯片的切割中,通常装有复杂微小元件的芯片及存在中空部结构的芯片对清洗水及加工负荷的承受能力不太强。而隐形切割在加工、清洗时不使用水,且对芯片正反面基本无损伤,因此有望实现高品质的MEMS加工。
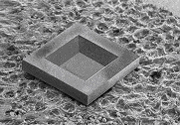
缩小切割道宽度
隐形切割可以缩小切割道宽度(切割宽度),因此,和通常的切割相比,有望增加1枚晶片内的芯片制造个数。本加工方法对于加工线性传感器等长条形芯片尤其有效。
芯片制造个数模拟
通过减小芯片间隔,增加晶片内长条形芯片个数的示例

Hasen切割
Hasen切割是在激光切割过程中,根据事先设定的距离,反复开关激光进行切割的方法。根据开/关设定不同,可以加工各种形状。
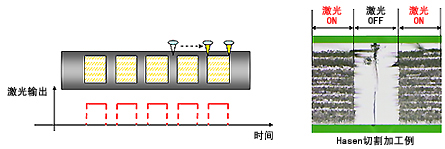
Hasen切割的应用例
- 具有规则性尺寸的复合芯片的晶片切割
利用Hasen切割,可对形状不规则的芯片所组合的晶片进行加工,而以往的激光全切割加工及刀片切割机则无法实现该加工。
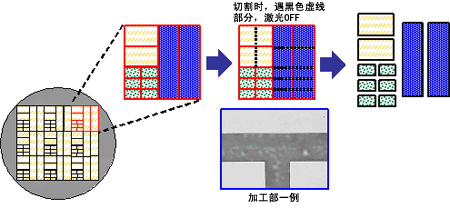
- 异形芯片的加工
可以加工出6边形、8边形・・・等多边形芯片,而且没有浪费。根据条件,有时还可加工非正多边形芯片。
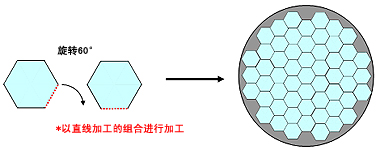

- 芯片偏移加工
如下图所示,Hasen切割还适用于切割道不连续的芯片布局。因此,尤其是在单个芯片面积较大、晶片价格昂贵、或加工长条形芯片等情况下,可有效应用晶片,增加芯片制造个数。
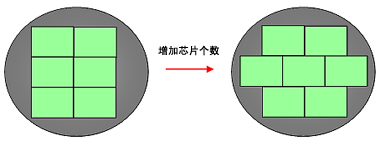
通过Die Separator设备的芯片分割
芯片分割(Die Separator)设备是通过扩展切割胶带,对隐形切割后在内部产生变质层的晶圆进行芯片分割的设备。首先,将隐形切割后的晶圆放置于扩展工作盘,通过扩展切割胶带进行分割。下一步,在热扩工作盘上,通过200℃以上的高温使切割胶带热收缩(heat shrinking),消除切割胶带外围所产生的松弛。
通过这些,不必重新贴换胶膜,可直接将胶膜框架送往下一道工序。





