플라스마 다이싱 가공
솔루션
플라스마 다이싱은, 진공으로 드라이 에칭을 실행하는 것으로 웨이퍼를 가공하는 기술입니다.
플라스마 다이싱에서 사용되는 Bosch프로세스※(그림참고)는, 빠르고 High Aspect Ratio, Narrow street에서의 가공을 실현합니다.
최근 Discrete device나 RFID등에서는 웨이퍼 1장당 칩 생산수를 늘리기 위해 사용되고 있습니다. 또한, 모바일 기기나 IoT용으로 지금보다 수요가 높은 작은 칩 디바이스에서 높은 생산성이 지금 이상으로 요구되고 있습니다.
더 나아가 무결점(zero defect)이 요구되는 차량용 반도체등 고품질 가공이 요구되는 디바이스에도 플라스마 다이싱은 대응이 가능합니다.
※독일 Robert Bosch GmbH에 의해1992년에 개발된 방법
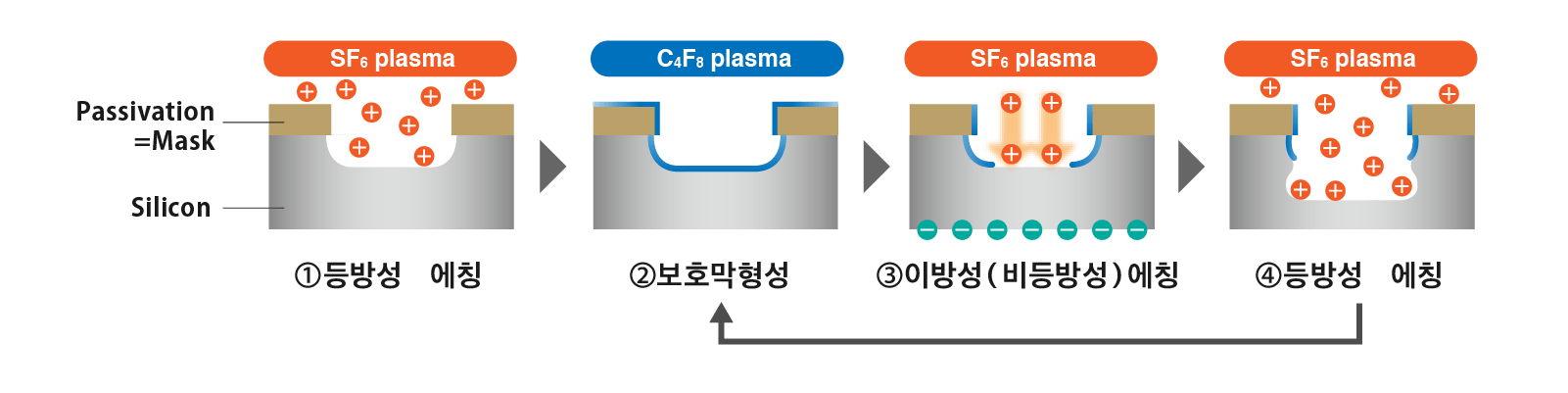
플라스마 다이싱의 장점
작은 칩 디바이스의 생산성 향상
웨이퍼 위의 모든 커트 라인을 동시에 가공하기 때문에, 작은 칩 디바이스에서도 높은 UPH를 유지합니다. Narrow street에도 대응하기 때문에 칩 생산수를 높일 수 있습니다.-
다양한 형상으로의 가공에 대응
드라이 에칭에 의해 가공되기 때문에, 마스크 패턴에 맞는 형상으로 가공을 실현합니다.
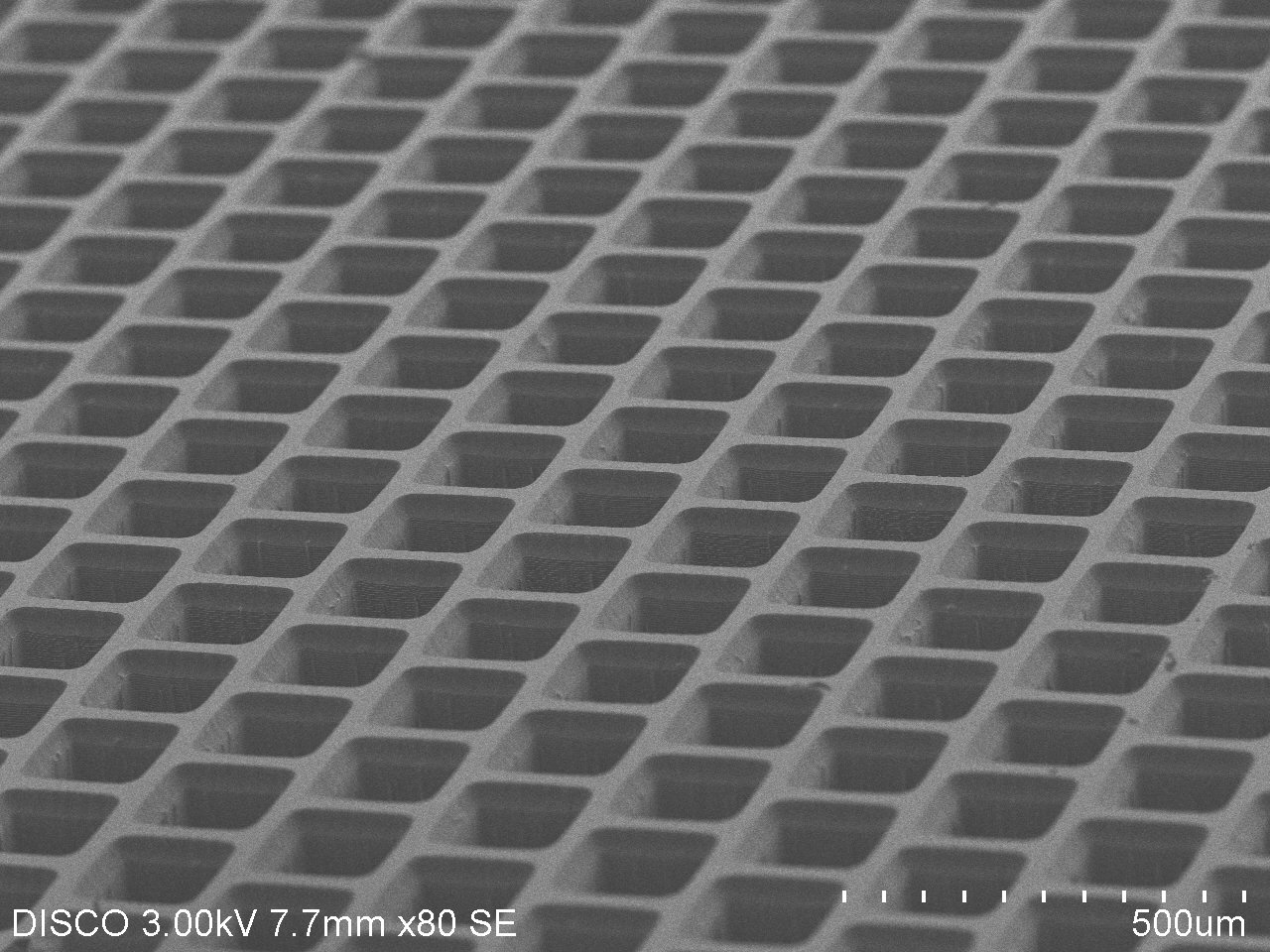

하이 클린 프로세스
플라스마 다이싱은 기계 가공이 아닌 화학반응에 의한 드라이 프로세스이기 때문에, 가공 후의 잔여물이나 용해 파편 등이 발생하지 않습니다.칩 강도의 향상
기계적 데미지가 없고, 열영향이 적은 플라스마 다이싱을 사용하는 것으로, 칩 강도의 향상이 가능합니다.
어플리케이션
디스코가 제공하는 토탈 솔루션
보통의 디바이스에서는, street상에 플라스마 다이싱의 저해가 되는 막이나 메탈 등이 존재합니다. 그렇기 때문에 플라스마 다이싱의 전 처리로서, 그것들을 제거하는 공정이 필요합니다.
디스코가 쌓아온 다양한 가공 기술, 어플리케이션에 의해 디바이스 형성 후의 Si 웨이퍼를 가공하는 것까지의 프로세스를 원스톱으로 제공합니다.
어플리케이션 예:
스트리트 상에 메탈이 형성된 Si웨이퍼의 가공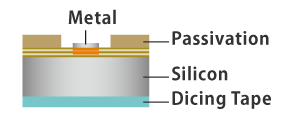
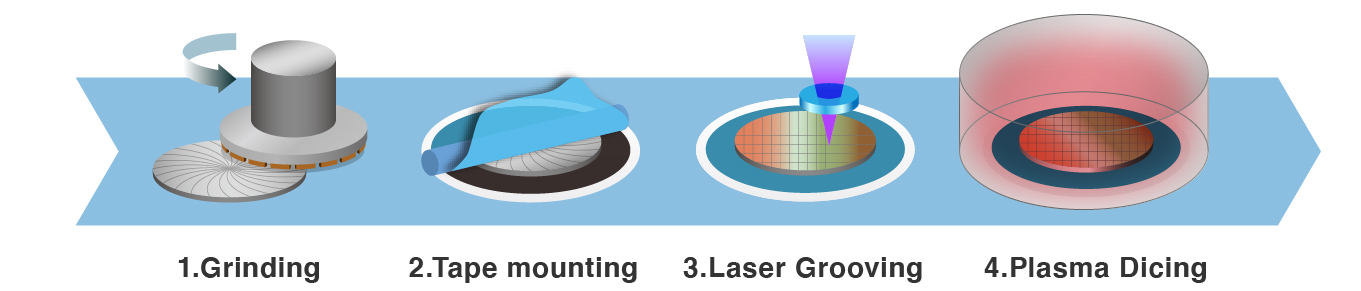
- Back면 그라인딩:백 그라인더/폴리셔에서 웨이퍼를 가공(박화)
- 테이프 마운팅:핸들링이 어려운 얇은 웨이퍼를 마운터로 테이프 프레임에 부착
- 레이저 그루빙:레이저 쏘로 스트리트 라인의 비활성화층이나TEG등의 메탈 부분을 제거
- 플라스마 다이싱:테이프 프레임에 마운터된 상태 그대로 플라스마 다이싱을 실시
어플리케이션 채용 실적
- Power device
- LED
- RFID
- RF filter
- MEMS
- TVS(제너 다이오드)등
미국Plasma-Therm사와의 업무제휴

당사는, 미국Plasma-Therm사와 2016년4월에 업무 제휴 계약을 체결해、당사의 플라스마 다이싱 장비를 사용한R&D,테스트 컷,장비 판매 및 애프터 서비스등,글로벌하게 서비스를 제공하고 있습니다.
문의
질문・상담이 있으시면 언제든 문의해 주십시오.

